В свете приближающегося барьера в производстве чипов, которым становится невозможность дальнейшего снижения масштаба техпроцессов, на первый план выходит многокристальная упаковка кристаллов. Производительность процессоров будущего будет измеряться сложностью или, лучше сказать, комплексностью решений. Чем больше функций будет возложено на небольшой чип процессора, тем мощнее и эффективнее будет вся платформа. При этом сам процессор будет представлять собой платформу из массы разнородных кристаллов, соединённых высокоскоростной шиной, которая будет ничуть не хуже (по скорости и потреблению), чем если был это был один монолитный кристалл. Говоря иначе, процессор станет и материнской платой и набором плат расширения, включая память, периферию и прочее.
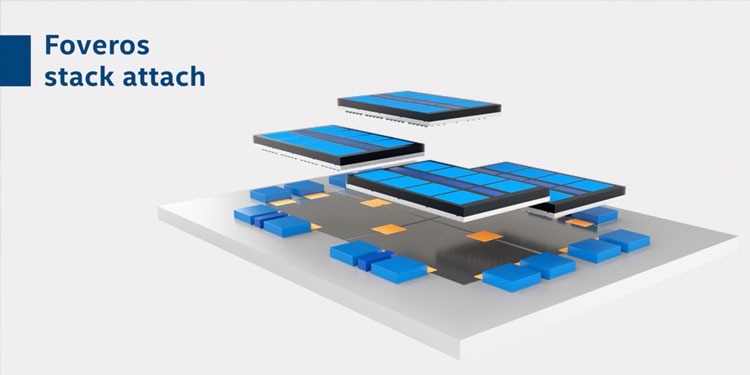
Компания Intel уже продемонстрировала реализацию двух фирменных технологий для пространственной упаковки разнородных кристаллов в один корпус. Это технологии EMIB и Foveros. Первая представляет собой встроенные в «монтажную» подложку мосты-интерфейсы для горизонтальной компоновки кристаллов, а вторая ― это трёхмерная или стековая компоновка кристаллов с использованием, в том числе сквозных вертикальных каналов металлизации TSVs. С помощью технологии EMIB компания выпускает FPGA поколения Stratix X и гибридные процессоры Kaby Lake G, а технология Foveros будет реализована в коммерческих продуктах во второй половине текущего года. Например, с её помощью будут выпускаться ноутбучные процессоры Lakefield.
Безусловно, Intel не будет на этом останавливать и продолжит активно развивать технологии по прогрессивной упаковке кристаллов. Конкуренты занимаются тем же самым. Как TSMC, так и Samsung разрабатывают технологии для пространственной компоновки кристаллов (чиплетов) и намерены дальше тянуть одеяло новых возможностей на себя.
![]()
На днях на конференции SEMICON West компания Intel вновь показала, что её технологии для многокристальной упаковки развиваются хорошими темпами. На мероприятии представлены три технологии, реализация которых состоится в ближайшее время. Надо сказать, что все три технологии не станут индустриальными стандартами. Все разработки Intel бережёт для себя, и будет предоставлять лишь клиентам на контрактное производство.
Первой из трёх новых технологий для пространственной упаковки чиплетов заявлена Co-EMIB. Это сочетание технологии недорогих мостов-интерфейсов EMIB с чиплетами Foveros. Многокристальные стековые конструкции Foveros можно связывать горизонтальными линками EMIB в сложные системы без ухудшения пропускной способности и снижения производительности. В Intel утверждают, что задержки и пропускная способность всех многоуровневых интерфейсов будет не хуже, чем в монолитном кристалле. Фактически за счёт предельной плотности размещения разнородных кристаллов общая производительность и энергоэффективность решения и интерфейсов будут даже выше, чем в случае монолитного решения.
Впервые технология Co-EMIB может быть реализована для производства гибридных процессоров Intel для суперкомпьютера Aurora, ожидаемого к поставке в конце 2021 года (совместный проект Intel и Cray). Прототип процессора был показан на SEMICON West в виде стека из 18 небольших кристаллов на одном большом кристалле (Foveros), пара которых соединялась горизонтально соединением EMIB.
Вторая из трёх новых технологий пространственной упаковки чипов Intel называется Omni-Directional Interconnect (ODI). Эта технология не что иное, как использование интерфейсов EMIB и Foveros для горизонтального и вертикального электрического соединения кристаллов. Вынести ODI отдельным пунктом заставило то, что компания реализовала питание чиплетов в стеке с помощью вертикальных TSVs-соединений. Этот подход даст возможность эффективно развести питание. При этом сопротивление 70-мкм TSVs-каналов для питания существенно снижено, что уменьшит число необходимых для подвода питания каналов и освободит площадь на кристалле для транзисторов (например).
Наконец, третьей технологией для пространственной упаковки Intel назвала интерфейс кристалл-кристалл MDIO. Это шина Advanced Interface Bus (AIB) в виде физического уровня для межкристального обмена сигналами. Строго говоря, это второе поколение шины AIB, которую Intel разрабатывает по заказу DARPA. Первое поколение AIB было представлено в 2017 году с возможностью передавать по каждому контакту данные со скоростью 2 Гбит/с. Шина MDIO обеспечит обмен на скорости 5,4 Гбит/с. Этот линк станет конкурентом шины TSMC LIPINCON. Скорость обмена LIPINCON больше ― 8 Гбит/с, но у Intel MDIO выше показатель плотности Гбайт/с на миллиметр: 200 против 67, так что Intel заявляет о разработке, которая не хуже, чем у конкурента.








